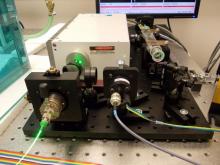
Název etalonu: Státní etalon délky a tvaru v oboru nanometrologie
Pracoviště: odd. 6014 ČMI OI Brno
Garant: Mgr. Petr Klapetek, Ph. D.,
Metrologický rastrovací sondový mikroskop je zařízení, které vbylo vyvinuto v rámci řešení grantového programu projektu „Nanotechnologie pro společnost“ GAAV a představuje hlavní etalon pro měření v nano- a mikroměřítku na oddělení nanometrologie.
Jádrem systému je interferometrický systém vyvinutý Ústavem přístrojové techniky AVČR, využívající stabilizovaný Nd:YAG laser, který je vláknovou optikou rozveden do šesti interferometrických jednotek rozmístěných okolo polohovacího stolku od firmy Physik Instrumente. Využitím stabilizovaného laseru tak získáváme přímou návaznost v oboru délky. Nad stolkem je umístěna jednoduchá AFM hlava, která funguje jako pasivní senzor síly mezi hrotem a povrchem. Převážná část dílů konstrukce je vyrobena z invaru, teplotní stabilita systému je nicméně dále zvýšena uzavřením do komory s aktivní stabilizací teploty.
Zařízení se v roce 2008 účastnilo mezinárodního porovnání s ostatními metrologickými instituty a v současné době může být využito pro nejpřesnější měření, která můžeme v rámci ČMI v oboru nanometrologie zákazníkům poskytnout. Podrobnosti o konstrukci zařízení je možno nalézt v odborných publikacích, např. [1].
Kromě poskytování služeb veřejnosti je zařízení využíváno také pro výzkum v oblasti nejistot v SPM měřeních, zejména v souvislosti s otázkami šíření nejistot polohovacího systému do naměřených dat [2]. Výsledky těchto analýz jsou využívány i dalšími partnery v rámci řešení metrologických projektů na evropské úrovni.
Publikace:
[1] LAZAR J., KLAPETEK P., ČÍP O., ČÍŽEK M., ŠERÝ M.: Local probe microscopy with interferometric monitoring of the stage nanopositioning, Meas. Sci. Technol., 20, 084007
[2] KLAPETEK P., NEČAS D., CAMPBELLOVÁ A., YACOOT A., KOENDERS L.: Methods for determining and processing 3D errors and uncertainties for AFM data analysis, Meas. Sci. Technol., 22, 25501, 2011